|
硼(B)掺杂的P型单晶硅(Cz-直拉法)电池的光衰现象早在1973年已发现,该光衰之后被发现可一定程度恢复的。Jan Scht发现了该光衰主要是“B-O对”引起的并给出了该缺陷的结构(2003)。Axel Herguth提出了“再生态”理论解释初始光衰后功率恢复并保持稳定的原理(2006)。P型多晶硅电池的衰减则因氧含量相对少而恢复过
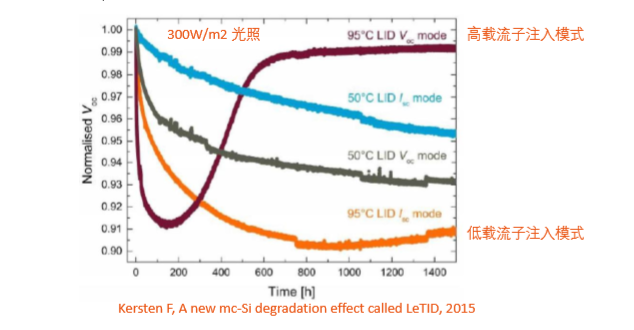 多晶PERC电池在暗退火处理(如150oC,10小时)时可发生类似的衰减行为,研究者认为该过程与LeTID有相同的机理,因此可以通过研究暗退火过程以确定LeTID的根本原理。UNSW发现P型Cz单晶硅、Fz单晶硅以及N型硅在暗退火后也会发生衰减(考虑到暗退火条件并不见于户外应用,没有必要因此担心单晶PERC技术的产业应用)。UNSW发现了LeTID与氢的相关性;M. A. Jensen认为LeTID是氢与硅片中的一种和几种缺陷共同作用导致的(Evaluating root cause: The distinct roles of hydrogen and firing in activating light andelevated temperature-induced degradation,2018);Kenta Nakayashiki认为根本原因可能是两个:1氢和深能级施主缺陷共同形成的点缺陷;2含Cu复合缺陷的构型变化(Engineering Solutions and Root-Cause Analysis for Light-Induced Degradation in p-Type Multicrystalline Silicon PERC Modules, 2016);Mallory A. Jensen则发现杂质元素Cu和Ni在LeTID过程中起着关键作用 (Solubility and Diffusivity: Important Metrics in the Search for the Root Cause of Light and Elevated Temperature-Induced Degradation, 2018) 总之,多晶PERC的LID(或称LeTID)的根本原因仍没有定论,考虑到各研究者都有实验依据,光衰很可能是多种因素共同作用导致的。对于产业化的解决上,多晶PERC生产商需要做的包括严控多晶硅片质量(采用高品质硅料),长时间‘再生’处理以及严控电池出厂光衰测试(75oC测试,提高抽测频次)。考虑到18年下半年多晶硅片处于亏本销售的情况,差的硅料、回料很可能被用到,质量相对较差的硅片制成的多晶PERC组件在系统中存在较高的潜在风险。 目前晶硅电池LeTID的测试标准正在讨论中,对于多晶PERC的光衰管控只有出厂测试才有意义,仅仅看第三方的送样测试结果的参考价值不大,一方面多晶硅片来自铸锭不同位置,硅片内部缺陷的情况有不同;另一方面单片电池/组件是可以通过特殊处理做到低光衰的。 4.总结 A.P型PERC电池的光衰明显高于常规BSF电池,因此需要进行“再生”处理; B.单晶PERC电池的光衰以“B-O”光衰为主,原理上可通过光注入、电注入及掺Ga来解决,但对制造商技术水平提出更高要求,投资者需选择可靠供应商。 C.多晶PERC电池的光衰机理复杂,也会发生“再生”过程但耗时很久,产业化需要使用高品质硅片并加强电池的出厂光衰管控。 |